データシートの熱パラメータとICジャンクションの温度について

役立つ情報を毎月お届けします
プライバシーを尊重します
はじめに
データシートの熱抵抗パラメータを変換して、意味のある設計上の決定を行う方法については、多くの混乱があります。この入門寄稿文は、今日のハードウェアエンジニアが、シータかプサイかを選択するかどうか、これらの値を計算する方法、そして最も重要なこととして、これらの値を実際の方法で設計に適用する方法など、データシートにある熱パラメータを解読する方法を理解するのに役立ちます。本稿では、アプリケーション周辺の温度との関係、およびそれらがPCB温度またはIC接合部温度とどのように比較されるかについても説明します。最後に、消費電力が温度によってどのように変化するか、およびこの特性を使用してクールな実行とコスト最適化のソリューションを実現する方法について説明します。
電気と熱の類似性
熱量をより簡単に理解するために、熱量と電気量の間にはいくつかの類推できることがあります。表1と表2は、電気量と熱量、およびそれらの材料による定数を比較しています。
表1 : 電気量と熱量の類似した関係 (1)

注 :
- この表の内容は、Technische Temperaturmessung: Volume I, Frank Bernhard, ISBN 978-3-642-62344-8からのものです。
- elは電気的値、thは熱的値を示します。
表2 : さまざまな材料の材料定数と変数
| 式記号 | 対象量 | 詳細と例 | 値 | 単位 |
| ρ (ギリシャ文字のロー) | 密度 | 物質の体積質量密度 | $$kg\over {m^3}$$ | |
| λ (ギリシャ文字のラムダ) | 熱伝導率 | 材料の熱伝導率、熱を伝える能力 | $$W\over m \times K$$ | |
| 銅 | 388 | |||
| アルミニウム | 205 | |||
| ケイ素 | 180 | |||
| はんだ (16% Cu) | 62 | |||
| セラミック BaTio3 (MLCCs) | 2.9 | |||
| ダイ付着エポキシ | 2.4 | |||
| モールドコンパウンド | 1 | |||
| FR4 平面内 ↔ | 0.8 to 1 | |||
| FR4 平面貫通方向 ↕ | 0.2 to 0.4 | |||
| 空気 | 0.026 | |||
| κ (ギリシャ文字のカッパ) | 電気伝導度 | 電荷の輸送を可能にする材料の能力 | $$1 \over \Omega \times m$$ | |
| 銅 | 58.6x10-6 | |||
| アルミニウム | 37.7x10-6 | |||
| はんだ (13% Cu) | 7.6x10-6 | |||
| c | 比熱 | 物質1kgの温度を1K上げるのに必要な熱量 | $$Ws \over kg \times K$$ | |
| 4179.6 | ||||
| FR4 | 1300 | |||
| アルミニウム | 900 | |||
| 銅 | 389 | |||
| L | 長さ | 1次元の物体サイズ | m | |
| A | 範囲 | 形状の2次元拡がり | m2 | |
| V | ボリューム | 境界で囲まれた3次元空間 | m3 | |
| θJA (ギリシャ文字シータ) | 熱抵抗 | 定義されたPCBでの接合部から空気への熱抵抗 | K/W | |
| θJC (ギリシャ文字シータ) | 熱抵抗 | 定義されたPCBの接合部からケースまでの熱抵抗 | K/W | |
| ΨJTまたは ΨJB (ギリシャのプサイ) | 熱抵抗特性 | 接合部からケース (上部) または基板までの熱抵抗。測定に基づく特性パラメータ | K/W |
気的および熱的アナロジーの式
電気量と熱量はネットワークで計算でき、キルヒホッフのルールに相当します (表3を参照)。
図3 : 電気式と熱的プロセスの式の類似性 (3)

注 :
3. この表の内容は、Technische Temperaturmessung: Volume I, Frank Bernhard, ISBN 978-3-642-62344-8からのものです。
データシートでの熱抵抗 (θJAおよびθJC)
図1は、熱パラメータを理解するための例として、MPSのDCスイッチング電源ICであるMPQ4572 を紹介しています。このデータシートには、θJAとθJCの2つの熱抵抗パラメータが指定されています。これらのパラメーターについては、本稿で詳しく説明します。
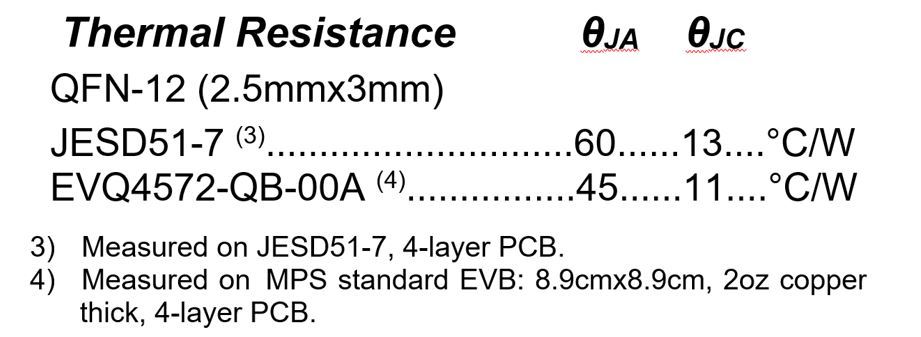
図1 : データシートの熱抵抗 (θJAおよびθJC) の仕様
図2は、5V/2A出力の典型的なMPQ4572アプリケーション回路を示しています。

図2 : MPQ4572の5V/2A出力用の代表的なアプリケーション回路
接合部から周囲への熱抵抗 (θJA) とは何ですか?
θJAは、接合部から周囲温度までの熱抵抗として定義されます。これは、すべての熱伝達経路、銅配線、スルーホール、および空気の総合条件の合計を介して接合部から周囲温度に熱を放散するデバイスの能力の尺度です。
したがって、特定のθJAは、その定義済み PCB に対してのみ有効です。θJAがすべてのPCBで使用できる定数であると考えるのはよくある間違いです。θJAにより、JEDSD51-7などの共通PCB上のさまざまなパッケージを比較できます。たとえば、MPQ4572が4層 JESD51-7 PCB (4) 上にある場合、そのθJAは式 (1) で計算できます。
$$\theta_{JA} = 60 \frac{K}{W}$$注 :
4. JESD51-7は4層PCBであり、リード付き表面実装パッケージ用の非常に効果的な熱伝導率のテストボードです。114.3mm × 76.2mmです。その測定方法は https://www.jedec.org/ にあります。
MPQ4572が4層の場合、2オンス。銅MPSテストPCB (8.9cm x 8.9cm)、そのθJAは式 (2) で計算できます。
$$\theta_{JA} = 45 \frac{K}{W}$$図3は、MPQ4572の評価ボードであるEVQ4572-QB-00Aを示しています。

図3 : EVQ4572-QB-00A評価ボード
EVQ4572-QB-00Aの消費電力は、RT = 25°C で 1.1W です。JESD51-7ボードでは、ジャンクション温度 (TJ) は式 (3) で見積もることができます。
$$T_J = 60 \times \frac{K}{W} \times 1.1W + 25º = 91ºC $$接合部からケースへの熱抵抗 (θJC) とは何ですか?
θJCは、パッケージ底面の接合部からケースまでの温度の熱抵抗として定義されます。この温度は、ピンの近くで測定されます。θJCと式 (4) を使用して接合部温度を計算します。
$$T_J = (θ_{JC} \times Heatflow_{JC}) + T_C$$ここで、HeatflowJCは接合部からケースに流れる熱です。HeatflowJCは式 (5) で推定できます。
$$Heatflow_{JC} = Heatflow_{TOTAL} -Heatflow_{JT}$$ここで、HeatflowJTは、接合部から上面に流れる熱です。図4は、カスタムPCBの測定値としてθJCを使用できない理由を示しています。
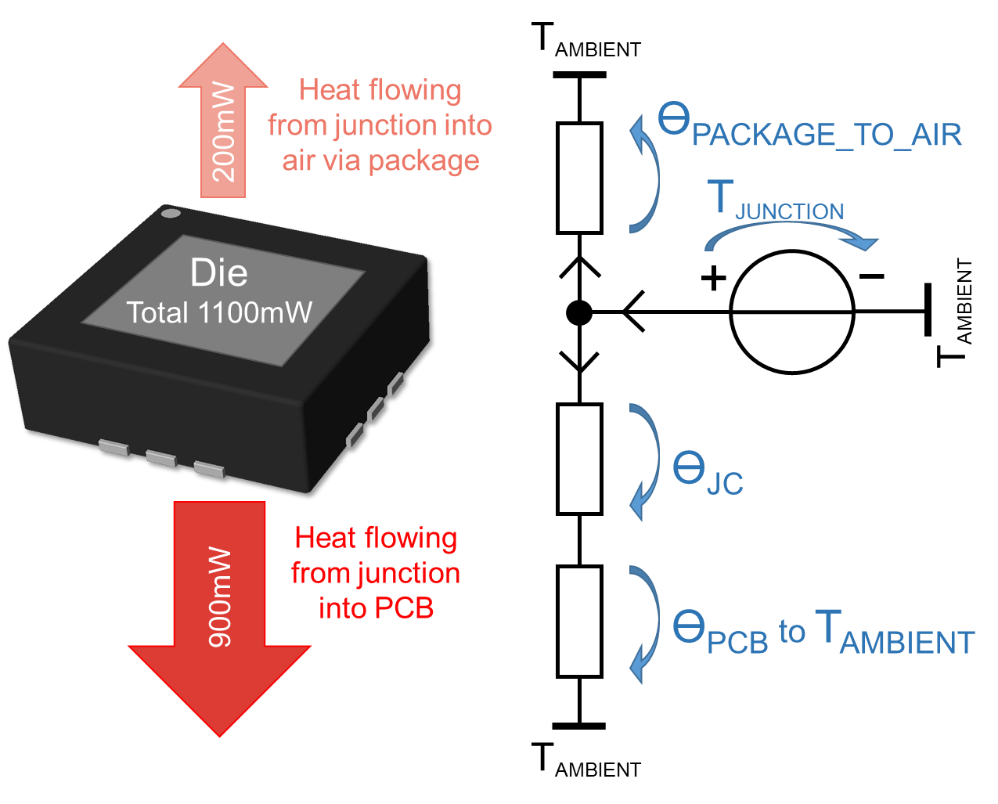
図4 : 接合部からケースへの熱抵抗 (θJC)
θJCは、次の2つの理由から、カスタムPCBでの測定には使用できません。
- カスタムPCBは、114.3mm x 76.2mmの固定寸法を持つJESD51-7 PCBとは異なる任意の寸法にすることができます。θJCの目的は、異なるパッケージの熱を伝達する能力を比較することです。したがって、JEDSD51-7 PCBのパラメータはすでに調査および測定されているため、その比較にはJEDSD51-7 PCBを使用する必要があります。
- カスタムPCBパッケージから流れる実際の熱は不明ですが、JEDSD51-7 PCBではすでにこのパラメータが測定されています。消費電力が1.1Wの例を考えてみましょう。この例では、熱の流れは2つの経路に分けられます。θJC (カスタムPCBでは不明)、および対流によってパッケージの表面から環境に放熱する熱の流れです。
ジャンクションからケーストップへ (ΨJT) およびジャンクションから基板へ (ΨJB)の熱特性パラメータは何ですか?
ギリシャ文字Ψの名前はプサイです。 ΨJTおよびΨJBは、JESD51-2Aに記載されています。プサイは、設計者が電気デバイスの総電力を知っている場合に使用できます。デバイスの電力は測定が容易なことが多く、プサイを使用して計算することで、ユーザーは基板の接合部温度を直接計算できます。
ΨJTとΨJBは、特定の環境下での測定によって特徴付けられる仮想パラメータです。接合部温度は式 (6) で計算できます。
$$T_J = \Psi_{JT} \times P_{DEVICE} + T_{SURFACE} $$ここで、TSURFACE (°C) はパッケージ上面の温度、PDEVICEはIC内の電力です。
式 (6) は、デバイスの総消費電力を使用します。これは、パッケージトップとピンの間の電力分布を知る必要がないことを意味します。これは、θJCの代わりに熱特性パラメータを使用する利点です。
ΨJTの一般的な値は、0.8°C/W and 2.0°C/Wです。より小さなパッケージはより低いΨJTを持つ傾向がありますが、より厚いモールド コンパウンドを備えたより大きなパッケージはより大きなΨJTを持っています。それぞれ式 (7) と式 (8) を使用して、シータ (θ) とpsi (Ψ) の差を推定します。
$$\theta_{12} = \frac {T_{position1} - T_{position2}} {Power_{Path12}}$$ $$\Psi_{12} = \frac {T_{position1} - T_{position2}} {P_{Device}}$$熱ネットワークによる計算
図5は、同等の線形電気ネットワークに変換できる熱ネットワークを示しています。 θJAは、接合部と周囲空気の間の等価熱抵抗の代表的な名前です。
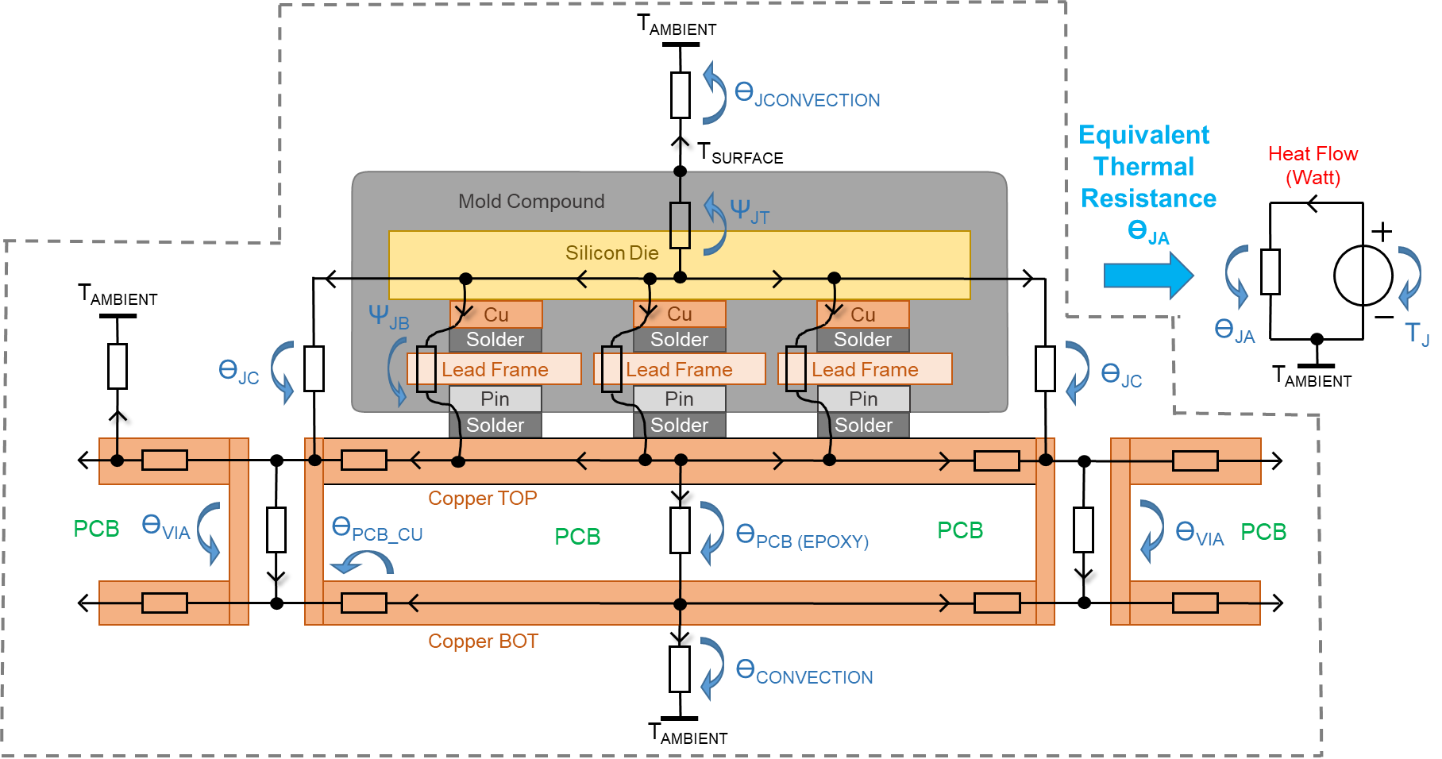
図5 : ICとPCBの熱ネットワークの図
熱抵抗 (°C/W)、熱流 (W単位)、および温度差 (ケルビン単位) の使用は、システムが熱安定性を備えている場合を表します。このネットワークに熱容量 (Ws/K) を追加すると、過渡応答を計算できます。
ネットワークのサイズと詳細レベルが大きくなるにつれて、このような計算はますます複雑になります。ハードウェア開発者は、寸法、材料定数、および熱流に関する正確な情報を欠いていることがよくあります。レイアウトおよび熱プログラムは、有限要素計算によって熱分布をグラフィカルに表すことができるため、大規模な数学的計算を回避するのに適しています。
レイアウトの推奨事項
デバイスを低温に保つには、ICと銅プレーン間の金属熱伝達経路をできるだけ短くすることをお勧めします。温度差の大きい2点を使用して、低温と高温の間の金属熱伝達パスを支援します。このシステムでは、スルーホール1は、より低温のスルーホール2と比較して、最上層と最下層の間の銅温度差が高くなります (図6を参照)。これは、スルーホール1がより多くの熱流を両層間で伝達できることを意味し、その結果、より効果的な冷却が実現します。パッケージの近くに配置されたスルーホールが最も効果的です。

図6 : DCスイッチング電源ICの熱イメージ
ICの近くに連続した銅の熱経路を配置することが不可欠です。不要な導線トラックで平面を切断しないでください。外層は、環境に熱を最もよく放射できます。ICの近くに配置された部品に熱放散を提供することは避けてください。放散すると熱伝導が損なわれます。
スルーホールは層間の熱の流れを改善します。GNDと安定した電位は、サーマルスルーホールに適した場所です。充填されたおよび塞がれたスルーホールは熱伝導率を改善し、表面実装技術 (SMT) パッドの直下に配置できます。大規模な熱レイアウトは、多くの場合、電磁適合性 (EMC) に有利です。EMC性能が悪化するため、dI/dtまたはdu/dtの高いスルーホール (スイッチングノードなど) は避けてください。
広く使用されているPCBエポキシ材料であるFR4は、エポキシ樹脂とガラス繊維が熱を十分に伝導できないため、熱伝導率が低くなります。PCBレイヤー間に銅スルーホールを配置して、レイヤー間の熱接続を改善します。特定のPCB材料は、FR4よりも4~8倍熱伝導率が高いです。
結論
MPSの MPQ4572を使用して、熱パラメータが電気量およびネットワークにどのように類似しており、両方を相互に変換できるかを示しました。エンジニアがよく使用する電気量により、PCB、環境、および半導体間の相互作用における熱パラメータをすばやく理解できます。
デバイスのデータシートに一般的に記載されている熱抵抗パラメータ (θJAおよびθJC)により、設計者は異なるパッケージの熱特性を比較できます。特性化された熱抵抗 (ΨJTおよびΨJB) により、設計者はカスタムアプリケーションの接合部温度を計算できます。IC表面の温度測定により、正確なジャンクション温度を簡単に取得できます。
_______________________
興味のある内容でしたか? お役に立つ情報をメールでお届けします。今すぐ登録を!





アカウントにログイン
新しいアカウントを作成