モータ・ドライバ PCBレイアウトガイドライン - 第2部
Pete Millett、テクニカルマーケティングエンジニア、MPS
この記事の第1部では、モータ・ドライバICを使用してプリント回路基板 (PCB) を設計するための一般的な推奨事項をいくつか示しました。これには、適切な特性を得るために注意深いPCBレイアウトが必要です。第2部では、一般的なモータ・ドライバICパッケージを使用するための特定のPCBレイアウトの推奨事項について説明します。
リードパッケージのレイアウト
SOICやSOT-23パッケージなどの標準的なリード付きパッケージは、低電力モータ・ドライバによく使用されます (図6を参照) 。
図6 : SOT23およびSOICパッケージ
リード付きパッケージの電力消費容量を最大化するために、MPSは「リードフレーム上のフリップチップ」構造を使用しています (図7を参照) 。ダイは、ボンドワイヤを使用せずに、銅バンプとはんだを使用して金属リードにボンディングされます。これにより、熱がダイからリードを介してPCBに伝わります。
図7: リードフレーム構造のフリップチップ
熱性能を最大化するには、大電流を流すリード線に大きな銅領域を取り付ける必要があります。モータ・ドライバICでは、通常、電源、グランド、および出力ピンが銅領域に接続されています。
図8: フリップチップ SOIC PCBレイアウト
図8は、リードフレームSOICパッケージのフリップチップの一般的なPCBレイアウトを示しています。ピン2はデバイスの電源ピンです。銅領域が最上層のデバイスの近くに配置されており、いくつかのサーマルビアがこの領域をPCBの裏側の銅に接続していることに注意してください。ピン4はアースであり、最上層の銅製アースに接続されています。ピン3はデバイス出力であり、大きな銅線領域にも配線されます。SMTパッドにはサーマルレリーフがないことに注意してください。それらは銅の領域にしっかりと接続されています。これは、良好な熱特性にとって重要です。
QFNおよびTSSOPパッケージ
TSSOPパッケージは長方形で、2列のピンを使用します。モータ・ドライバICに使用されるTSSOPパッケージには、通常、パッケージの下側に大きな露出パッドがあり、デバイスから熱を取り除くために使用されます (図9を参照) 。
図9: TSSOPパッケージ
QFNパッケージは、パーツの外側の端の周りにパッドがあり、デバイスの下側の中央に大きなパッドがあるリードレスパッケージです (図10を参照) 。この大きなパッドは、ダイから熱を抽出するために使用されます。
図10 : QFNパッケージ
これらのパッケージから熱を取り除くには、露出したパッドに十分にはんだ付けされた接続を行う必要があります。このパッドは通常グランド電位にあるため、PCBグランドプレーンに接続できます。理想的には、サーマルビアはパッド領域に直接配置されます。下の図11に示す例では、18個のビアのアレイが使用されており、完成した穴の直径は0.38mmです。このビアアレイの計算された熱抵抗は約7.7°C/Wです。
図11: TSSOP PCBレイアウト
通常、はんだのウィッキングを防ぐために、これらのサーマルビアには0.4mm以下の完成した穴のサイズが使用されます。SMTプロセスで必要な穴が小さい場合は、全体的な熱抵抗をできるだけ低く保つために、より多くの穴を使用する必要があります。
パッド領域内に配置されたビアに加えて、IC本体の外側の領域にもサーマルビアが配置されています。銅領域がパッケージの端を超えて広がる可能性があるTSSOPパッケージでは、これにより、熱がデバイスから上部の銅層を通過するための別のパスが提供されます。
QFNデバイスでは、パッケージの4つのエッジすべてにパッドがあり、最上層の銅を使用して熱を抽出することを防ぎます。PCBの内面または最下層のいずれかに熱を引き出すには、サーマルビアの使用が必須です。
以下のPCBレイアウトは、小型のQFN (4mm x 4mm) デバイスを示しています (図12を参照) 。露出したパッド領域には、9つのサーマルビアのみが収まります。このため、このPCBの熱性能は、図11に示すTSSOPパッケージほど良くありません。
図12 : QFN (4mm x 4mm) レイアウト
フリップチップQFNパッケージ
フリップチップQFN (FCQFN) パッケージは、通常のQFNパッケージに似ていますが、ワイヤボンドを使用してダイをパッケージパッドに接続する代わりに、ダイを上下逆さまにして、デバイスの下側のパッドに直接接続します。パッドはダイの発熱電力デバイスの反対側に配置できるため、小さなパッドではなく長いストライプとして配置されることがよくあります (図13を参照) 。
図13 : FCQFNパッケージ
これらのパッケージは、ダイの表面に銅のバンプの列を使用し、リードフレームに結合されます (図14を参照) 。
図14: FCQFN構造
FCQFNパッケージには、不規則な形状のパッドがあり、多くの場合、長くて細いストライプに配置されています。通常のQFNパッケージとは異なり、熱は1つの大きな中央パッドではなく、これらのパッドの多くから抽出されます。多くのパッドがあり、すべてが異なる信号を伝送し、それらに接続された銅領域を必要とするため、これはPCB設計に少し課題を生み出します。
通常のQFNパッケージで行われるのと同様に、小さなビアをパッド領域内に配置できます。電源プレーンとグランドプレーンを備えた多層ボードでは、ビアはこれらのパッドをプレーンに直接接続できます。その他の場合、ICから熱をより大きな銅領域に引き込むために、銅をパッドに直接取り付ける必要があります。
図15 : FCQFN PCBレイアウト
図15に、MP6540 電力段ICのPCBレイアウトを示します。このデバイスには、電源、アース、および3つの出力用の長いパッドがあります。パッケージは5mm x 5mmのみであることに注意してください。
デバイスの左側の銅の領域が電源入力です。この大きな銅領域は、ICの2つの電源パッドに直接接続されています。
3つの出力パッドは、ICの右側の銅線領域に接続されています。パッドを出た直後に、銅の領域が可能な限り拡張されることに注目してください。これにより、パッドから周囲空気への良好な熱伝達が提供されます。
ICの右側にある2つのパッド内の小さなビアの列に注目してください。これらのパッドはグランドに接続されており、PCBの裏側にソリッドグランドプレーンが配置されています。これらのビアは直径0.46mmで、完成したドリル穴は0.25mmです。ビアはパッド領域に収まるほど小さいです。
モータ・ドライバICを使用して設計を成功させるには、注意深いPCBレイアウトが必要です。この記事では、PCB設計者が優れた電気的および熱的性能を達成するのに役立ついくつかの実用的な提案を示しました。
_________________________
興味のある内容でしたか? お役に立つ情報をメールでお届けします。今すぐ登録を!


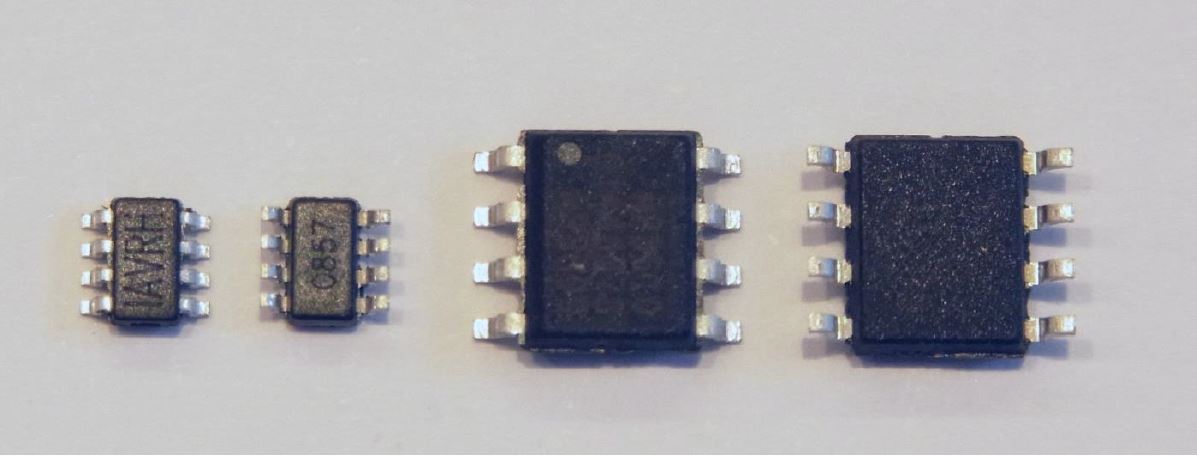
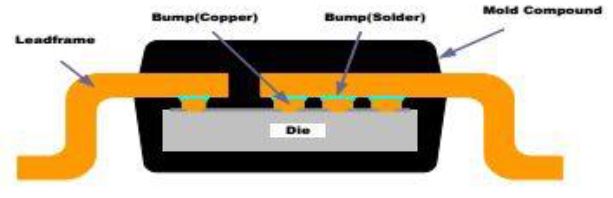
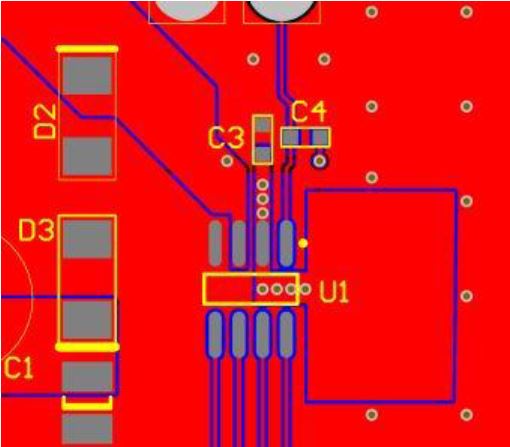
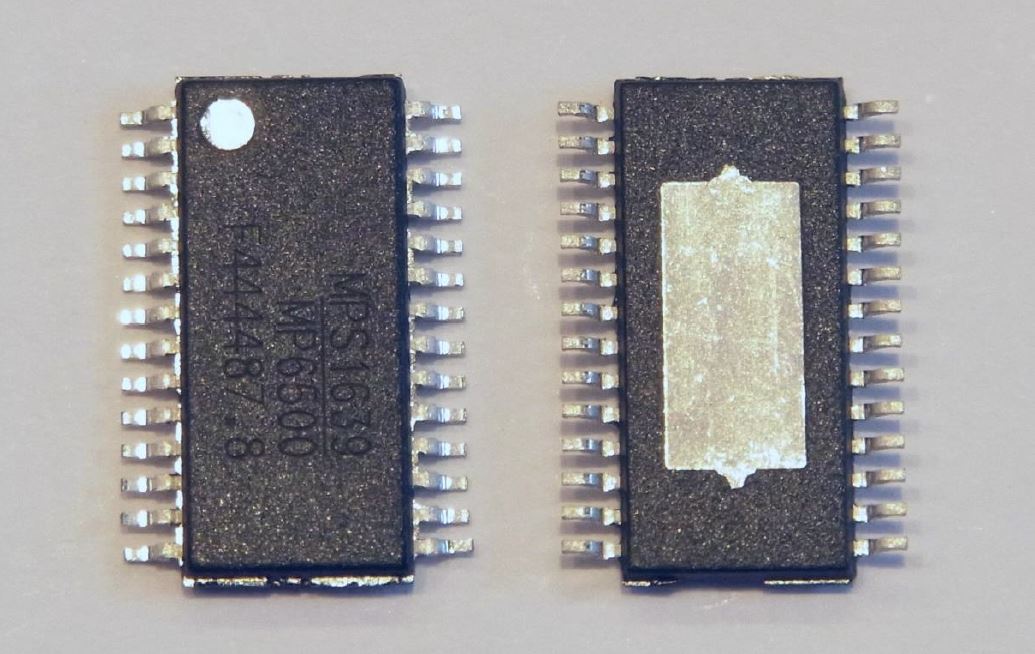
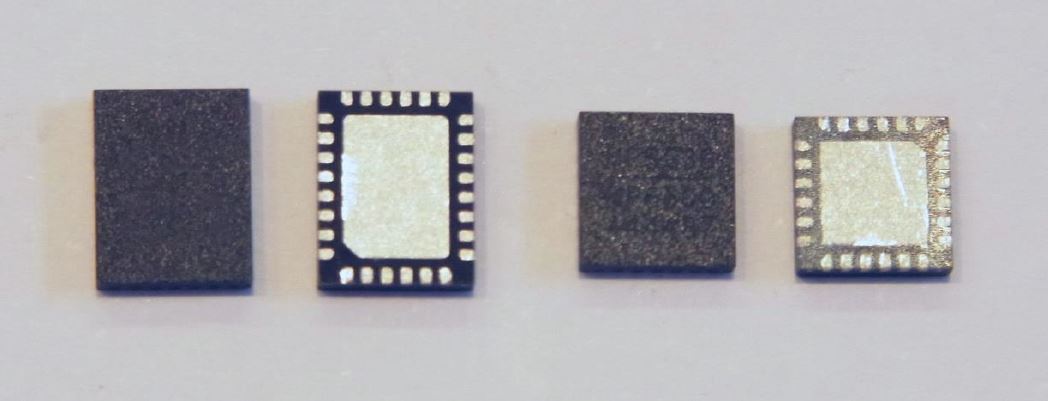
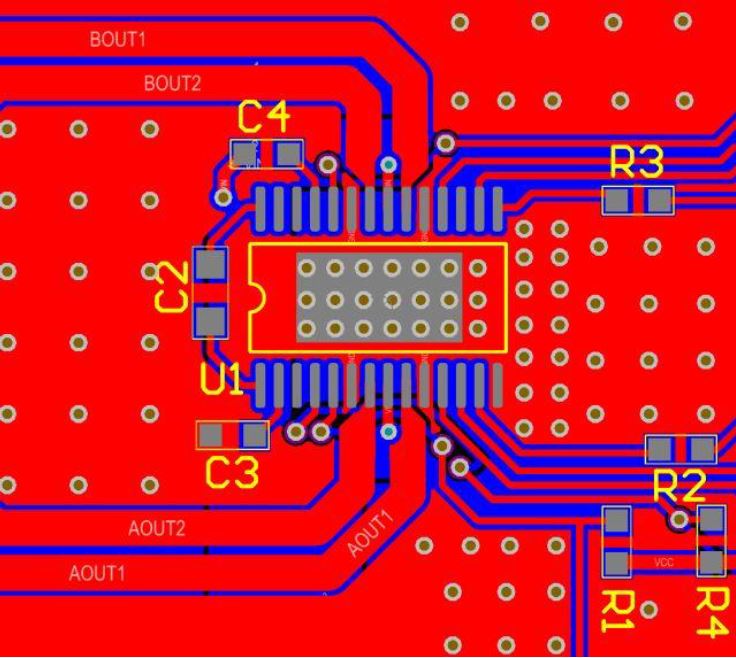
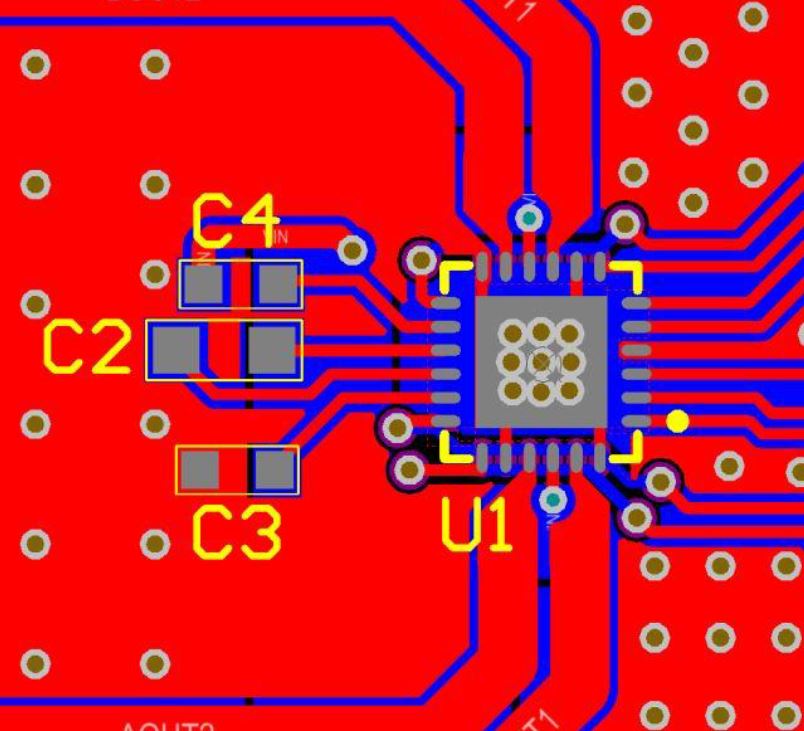
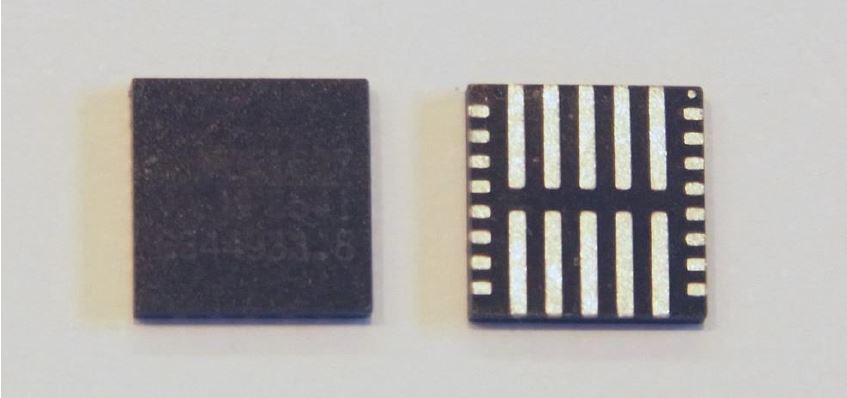
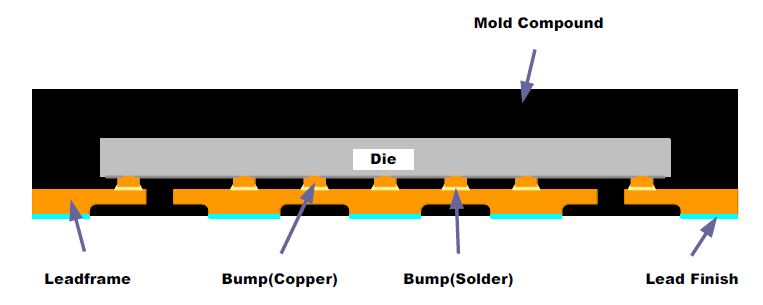
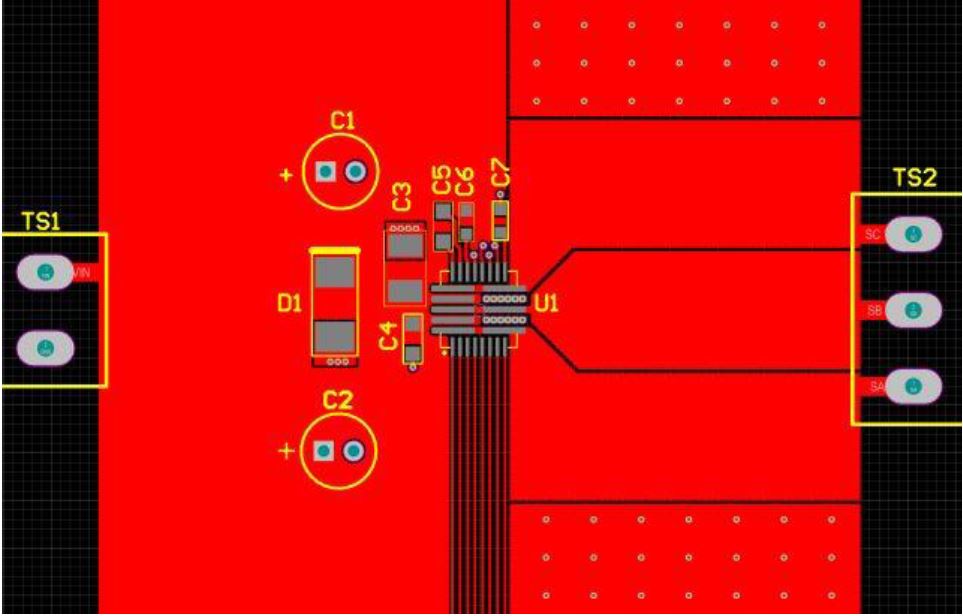
アカウントにログイン
新しいアカウントを作成